日月光半導體銷售與行銷資深副總張尹在開放運算平台峰會上明確指出,先進封裝技術正成為決定AI晶片競爭力的關鍵戰場,誰掌握了封裝創新,誰就握有未來十年的產業話語權。
2到7倍的效能需求年增幅、2到10倍的記憶體頻寬要求、105%的產能利用率——這三個數字精準描繪了當前AI浪潮對半導體產業帶來的前所未有衝擊。張尹直言不諱地指出,傳統半導體製造模式正面臨根本性挑戰,而先進封裝技術已成為產業競爭的新核心。

張尹提到,當AI經濟規模預計在2033年突破5兆美元,較目前不到2000億美元的規模成長25倍時,半導體產業必須重新思考技術路徑。尤其根據史丹佛大學人本人工智慧研究院《2025年人工智慧指標報告》,AI模型參數量已突破兆級規模,對運算能力和記憶體頻寬的需求正以指數級速度增長。
效率革命衝擊傳統邏輯 封裝技術價值凸顯
張尹提到前陣子的AI之亂:中國AI新創公司DeepSeek號稱以600萬美元的訓練成本,開發出媲美GPT-4o的AI模型,引發全球AI硬體股價重挫。根據市場數據,輝達單日暴跌16.9%,費城半導體指數重挫9.2%,市場開始重新審視高價AI晶片的價值邏輯。
然而張尹認為,這種效率革命反而凸顯了先進封裝技術的戰略價值。他表示,問題不在於AI需求會消失,而在於如何用更有效的方式滿足這些需求。當演算法效率大幅提升,降低了對純粹算力的依賴時,系統整合和封裝技術的重要性反而更加突出。
市場數據支持這個判斷。根據集邦資料,HBM記憶體產能已全面售罄,三大廠商SK海力士、三星和美光的2025年產能也基本被預訂一空。即使在DeepSeek引發的效率質疑聲中,記憶體廠商的訂單依然飽滿,這種供需失衡正推動封裝技術朝向更高整合度、更低功耗的方向發展。
張尹強調,當AI應用從實驗室走向大規模部署時,系統級的效能優化變得更加重要。「不是每個客戶都有能力像DeepSeek那樣重新設計演算法架構,大部分企業仍需要依賴硬體層面的效能提升,」他指出,這正是先進封裝技術的機會所在。
VIPack平台突圍 垂直整合重新定義封裝
面對市場挑戰和技術機遇,日月光在2022年推出VIPack垂直整合封裝平台,涵蓋FOCoS、FOCoS-Bridge、FOPoP、FOSiP等六大核心技術。張尹詳細解釋了該平台的技術突破:透過玻璃載體上的有機重新佈線層處理,精準連接小晶片和HBM,同時導入矽橋技術處理小於130微米的C4凸塊。

「從5倍矽晶圓尺寸到預計的10倍尺寸,我們必須克服翹曲邊緣處理、良率控制等關鍵挑戰,」張尹坦承技術難度。目前日月光已能穩定生產100×100毫米的大尺寸模組,但隨著客戶對更大面板的需求增加,良率管控成為決定競爭力的關鍵因素。
根據日月光官方資料,FOCoS技術已進入全面生產階段,相較於2.5D矽穿孔方案,能提供更優異的電氣性能和更具競爭力的成本結構,同時支援多達5層RDL互連和1.5/1.5微米的精細線寬,滿足下一代AI晶片的嚴苛要求。
為了進一步提升封裝效率和成本競爭力,日月光正積極研發300毫米和600毫米大面板技術。張尹提到,在5倍矽晶圓尺寸的封裝需求下,傳統300毫米晶圓每片只能產出7個模組,面板利用率僅57%。透過600毫米大面板技術,利用率可大幅提升至87%,不僅改善成本結構,更能滿足大規模AI應用對封裝產能的龐大需求。
平台化整合趨勢 技術創新尋求突破
張尹在演講中特別強調記憶體技術和功耗管理這兩大技術挑戰的緊密關聯性。根據JEDEC規範預測,2027年HBM4將實現16層垂直堆疊,單一HBM4設備頻寬可達1.6TB/s。以AMD和NVIDIA的產品規劃為例,每個AI加速器模組的HBM數量將從目前的8個大幅增加至16個,記憶體容量和頻寬需求呈現爆炸性成長。
與此同時,功耗管理成為更加嚴峻的挑戰。「到2030年,GPU功耗將達1500瓦,CPU也將達到500瓦,整個系統的運作溫度必須控制在30度C以下,」張尹指出,這比傳統氣冷系統的50-60度C運作溫度有顯著差異,對封裝技術提出了前所未有的要求。

為了應對這種雙重挑戰,日月光推出創新的Power SIP系統級封裝概念。張尹解釋,這項技術將第一級和第二級電壓調節器直接整合到封裝模組下方,大幅縮短功率傳輸路徑,不僅提高整體功率效率,更能在最需要的位置提供精準的電源管理。
根據產業報導,記憶體和邏輯晶片的界線正在模糊化。SK海力士計劃在HBM4基礎晶片上採用台積電的先進邏輯製程,這種跨領域合作模式反映了技術整合的新趨勢。張尹認為,未來晶圓代工廠在記憶體封裝領域的角色將日益重要,而日月光必須在這波變革中找到自己的競爭優勢。
為了解決高功耗AI系統的散熱難題,張尹透露日月光正與矽供應商合作開發微通道冷卻技術,並積極探索新型熱界面材料的應用,目標是為下一代AI晶片提供完整的熱管理解決方案。
光電整合開啟新局 產業生態全面重構
面向未來,張尹表示純粹的電子整合已無法滿足AI應用的極致需求,我們必須進入光電融合的新時代。日月光正積極布局共封裝光學技術,透過小晶片解決方案和光子整合技術,創造緊鄰CPU、GPU的光子引擎,實現更高頻寬傳輸和更低功耗表現。
這種技術路徑與台積電的CoWoS技術既競爭又合作。根據產業分析,目前大多數採用HBM的高階AI晶片都仰賴CoWoS封裝技術,但隨著模組尺寸不斷突破光刻工具的物理限制,產業急需新的技術突破。張尹認為,日月光的VIPack平台與共封裝光學技術的結合,將為客戶提供更多元化的選擇。
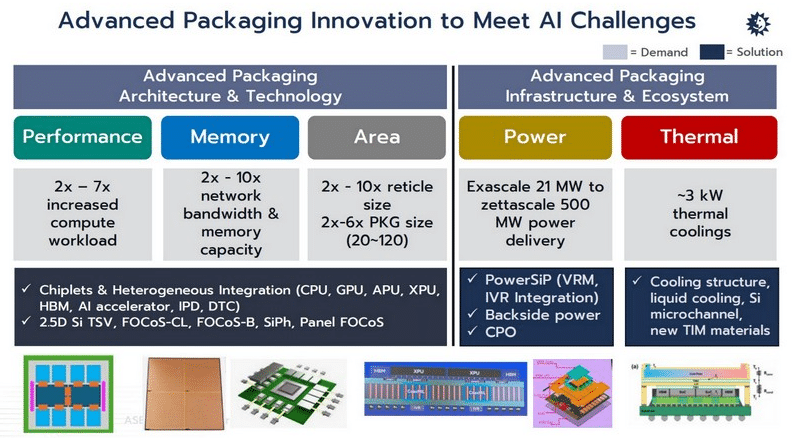
張尹表示,相信到2030年,半導體將成為價值1兆美元的產業,AI應用的普及和資料處理需求的持續成長,仍是推動產業發展的根本動力。關鍵在於如何在效率提升和效能需求之間找到平衡點。
然而,張尹也坦承,單純依賴製程微縮的時代已經結束。從小晶片整合、異質整合到矽光子學,從大面板封裝到背面供電技術,日月光正在構建一個涵蓋多項前瞻技術的完整生態系統,為客戶提供系統級的解決方案。
根據日月光投控財報,2024年第一季營收達到1,481.53億元,創下歷年同期新高紀錄,充分反映市場對先進封裝技術的強勁需求。但張尹也提醒,技術複雜度的急速提升意味著更高的研發投入和更長的技術驗證週期,這對整個產業的資源配置都是嚴峻考驗。
當AI應用從實驗性部署轉向大規模商業化,當HBM4技術開始進入量產階段,當共封裝光學技術從概念走向實用,整個半導體產業將迎來新一輪的技術重構和競爭洗牌。在這場決定未來十年科技走向的競賽中,掌握先進封裝技術的企業,將在AI時代的產業競爭中占據最有利的戰略位置。